流体解析例題 No.7
化学蒸着異シミュレーション解析
解析内容分類
| 定常 2次元 円筒座標 オブジェクト個数=少 化学反応、輻射 |
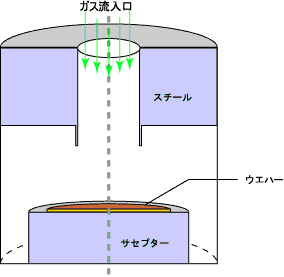 |
解析目的
化学蒸着によってウェハー表面にシリコンの薄膜を形成させる過程をシミュレートし、蒸着量の分布を求める。
解析条件
| 構造材質 | ウェハー | 半径12[cm]×厚さ0.5[cm] |
|---|---|---|
| サセプター | 半径15.5[cm]×厚さ10[cm] | |
| ガス流入部 | 半径6[cm]の円形 | |
| 流入ガス組成 | SiH4:11.3[wt%] N2:88.7{wt%} | |
| 流入ガス速度 | 1.345[m/s] | |
| 流入ガス温度 | 290[K] | |
| 系圧力 | 133[pa](1 Torr) | |
| 気体反応 | SiH4(g) <--> SiH2(g)+H2(g) Si2H6(g) <--> SiH4(g)+SiH2(g) SiH2(g)+Si2H6(g) <--> Si3H8(g) Si2H4(g) <--> 2SiH2(g) Si2H6(g) <--> Si2H4(g)+H2(g) |
|
| 表面反応 | SSiH4(g) <--> 2H2(g)+Si(s)M SiH2(g) <--> H2(g)+Si(s) Si2H6(g) <--> 3H2(g)+2Si(s) Si3H8(g) <--> 4H2(g)+3Si(s) Si2H4(g) <--> 2H2(g)+2Si(s) |
|
| 境界条件 | 流入部 | 流速・温度・ガス組成を規定 |
| 流出部 | 圧力を133[Pa]に規定 | |
| ウェハー温度 | 300[K]に固定 | |
| 固体壁面温度 | 290[K]に固定 |
解析結果
- 流速ベクトル図、各ガス成分の質量分布コンター図
- 蒸着量コンター図、蒸着量分布グラフ、温度コンター図
解析内容分類
| 計算の種類 | 解析次元 | 座標系 | オブジェクト | ||||
|---|---|---|---|---|---|---|---|
| 定常 | 2次元計算 | 直交or円筒座標 | 少 | ||||
| 非定常 | 3次元計算 | 一般化座標 | 多 | ||||
| 問題の種類 | |||||||
| 基本流れ解析 | 混流相 | 粒子挙動 | |||||
| 流れのみ | 自由表面 | ||||||
| 温度 | 化学反応 | ||||||
| 濃度 | 燃焼 | ||||||
| 圧縮性 | 移動格子 | ||||||
| 輻射 | 流体構造連成 | ||||||
| 項目 | 内容 |
|---|---|
| 解析内容策定 | 計算方式の選定・・・部材の配置と入力条件の策定 |
| モデル作成 | 形状入力・・・メッシュ作成:入力設定 |
| 計算実行 | 計算機稼働・・・計算状況監視 |
| 出力結果整理 | 図化出力、・・・報告書作成 |
クリックすると拡大します。





