超音波ワイヤーボンディング解析
ワイヤーボンディングとは
ワイヤーボンディングとは、半導体チップの電極部と、リードフレーム及び基板上の導体などとの間を金、アルミニウムなどの細いワイヤで接続する方法です。
小さなチップ上の電極をつなぐ必要があるので、精度の高い接続技術が要求されます。
ワイヤーボンディングの方法は大きく2種類に分類できます。
- US(Ultra Sonic、超音波)方式
ワイヤをツールで押しつけて数十KHz程度の超音波(ultra sonic)振動でこすりつけ、接合する方法。 - 熱圧着方式
接合に必要な熱を直接加熱で与えて接合。
半導体組み立ての場合はほとんど超音波方式で接合しています。超音波方式は接合時間が短く、熱による変形が少ないという利点あります。
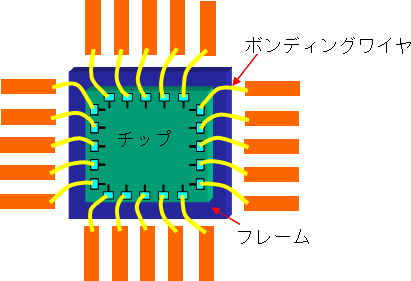
目的
ボンディングの際の条件は、環境や使用しているワイヤの種類、キャピラリ等によって異なるため、経験をもとに実験を繰り返して条件を決定しています。
しかし、実験では変形したり、割れたりする危険性があるため、シミュレーションで最適な条件を求めたい、という目的で解析を行いました。
解析モデル
下記のようにキャピラリ、ホーン等をモデル化し、中央断面の2次元モデルで解析を実行しました。キャピラリ中央部には金線をモデル化しており、ホーンの端部から100KHzで加振します。接触条件として、下記の3条件で解析を行いました。
- 金線とチップの接触がない場合
- 金線とチップが完全に結合している場合
- 金線とチップ間が10-6mm以下になったら接触する場合
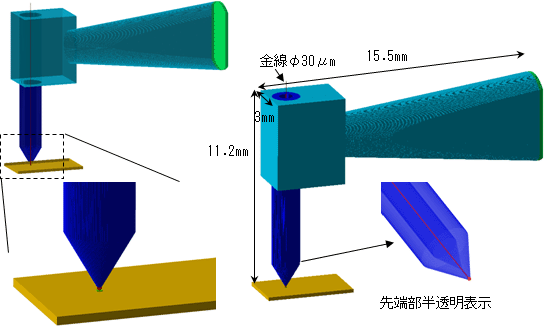 ワイヤーボンディング解析モデル
ワイヤーボンディング解析モデル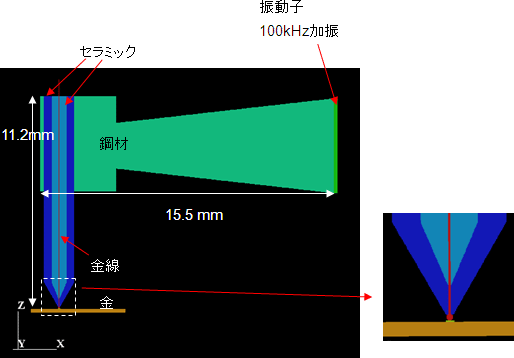 ワイヤーボンディング解析モデル(2次元)
ワイヤーボンディング解析モデル(2次元)解析条件
2次元モデル全要素数:約200万要素
メッシュサイズ:0.01mm
入力波形:周波数 100kHz、振幅 10mm
 ホーン端部の強制変位波形
ホーン端部の強制変位波形解析結果
金線とチップの接触がない場合
金線とチップが完全に結合している場合
金線とチップ間が10-6mm以下になったら接触する場合
 接触条件
接触条件